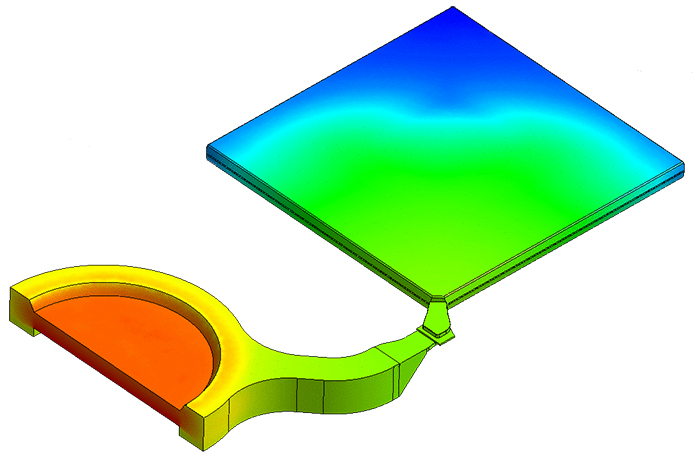
企業組 特別獎
![]()
作品名稱: 運用 Moldex3D 解決包封問題並將封裝流程最佳化
公司: STMicroelectronics
團隊成員: Marco Rovitto
 作品大綱
作品大綱
STMicroelectronics 工程師運用 Moldex3D IC Packaging 解決方案將樹酯充填不完整的風險降到最低。首先,此軟體能重現因流動行為不平衡而引發的包封形成情況。之後,運用 Moldex3D 模擬將封裝設計最佳化,降低發生問題的風險。最後,藉由更改幾何形狀發現對充填前推進有驚人效果,能在成型過程中避免產生結構瑕疵。Moldex3D 可用來成功在虛擬環境中預測問題,並可將模擬結果轉化並整合至新成品的封裝原型製造中。
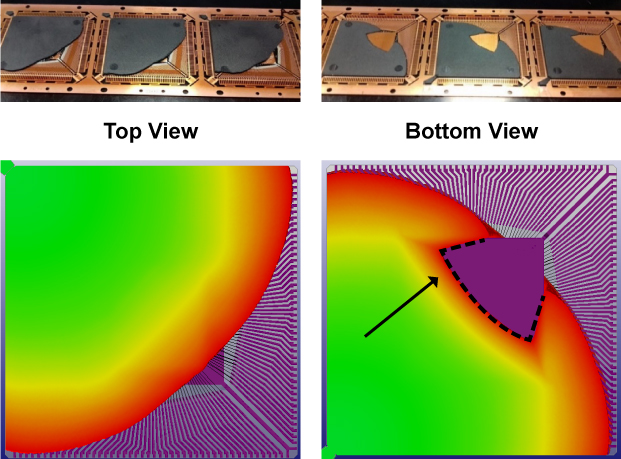
 挑戰
挑戰
- 改進不平衡的流動行為
- 減少結合線及包封
 解決方案
解決方案
根據 STMicroelectronics 設計師估計,藉由縮小標準配置的焊墊尺寸,就能減輕樹酯在模穴頂部與底部之間流動不平衡的情形。由於已確定導線架焊墊屬於關鍵位置,因此將其設計最佳化可對充填行為有極大助益。事實上,此方法能減少成品的關鍵結合線數量。因此,此解決方案藉由先從設計著手解決包封的問題,而非從耗時昂貴的實驗進行原型製造開始。
 效益
效益
- 找出關鍵結合線出現機率較高的位置
- 降低結合線會合角及形成包封的可能性
 使用產品(模組)
使用產品(模組)
 得獎團隊
得獎團隊


我十分榮幸能獲頒 2020 Moldex3D 全球模流達人賽的特別獎!這代表我多年來在 Moldex3D 上耗費的心血是值得的。