IC Packaging 晶片封裝模擬方案
IC封裝是以固態封裝材料 (Epoxy Molding Compound, EMC)及液態封裝材料(Liquid Molding Compound, LMC)進行封裝的製程,藉以達到保護精密電子晶片避免物理損壞或腐蝕。在封裝的過程中包含了微晶片和其他電子元件(所謂的打線)、熱固性材料的固化反應、封裝製程條件控制之間的交互作用。由於微晶片封裝包含許多複雜元件,故晶片封裝製程中將會產生許多製程挑戰與不確定性。常見的IC封裝問題如:充填不完全、空孔、金線偏移、導線架偏移及翹曲變形等。
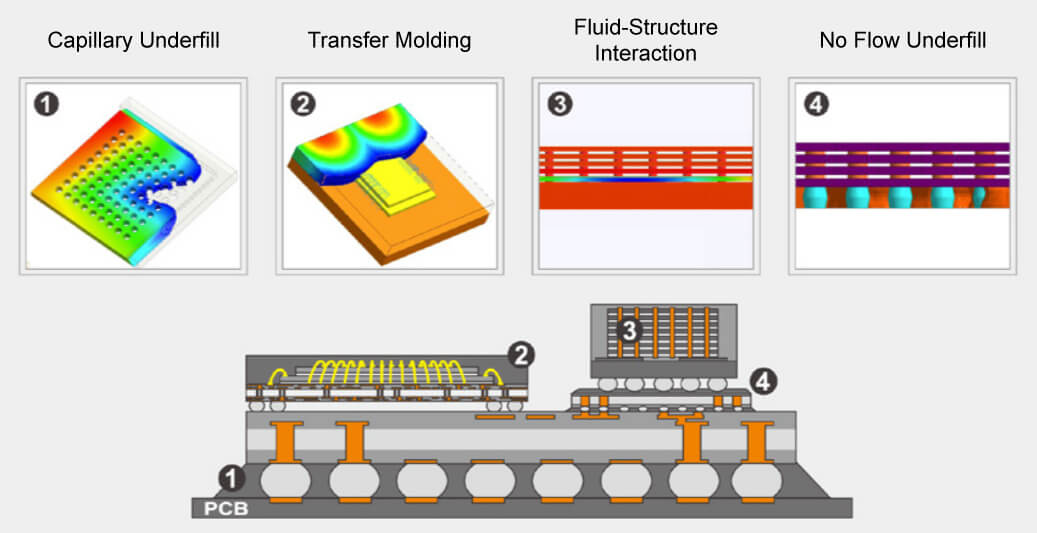
Moldex3D 解決方案
Moldex3D晶片封裝模組目前支援的分析項目相當完善,以準確的材料量測為基礎,除了基本的流動充填與硬化過程模擬;並延伸到其他先進製造評估,例如 : 金線偏移、晶片偏移、填充料比例、底部填充封裝、後熟化過程、應力分佈與結構變形等。透過精準的模擬可以預測及解決重大成型問題,將有助於產品品質提升,更可以有效地預防潛在缺陷;藉由模擬優化達到最佳化設計,並縮減製造成本和週期。
晶片布局評估
- 顯示動態熔膠流動行為
- 評估澆口與流道設計
- 優化流動平衡
- 避免產生氣泡缺陷

結構驗證
- 應用流固耦合(fluid-structure interaction)演算法預測金線、導線架、晶片偏移、晶片變形等行為
- 可與ANSYS及Abaqus整合,共同分析結構強度
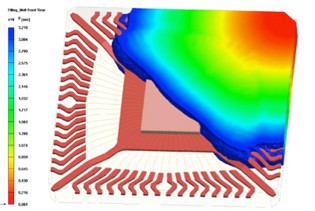 |
 |
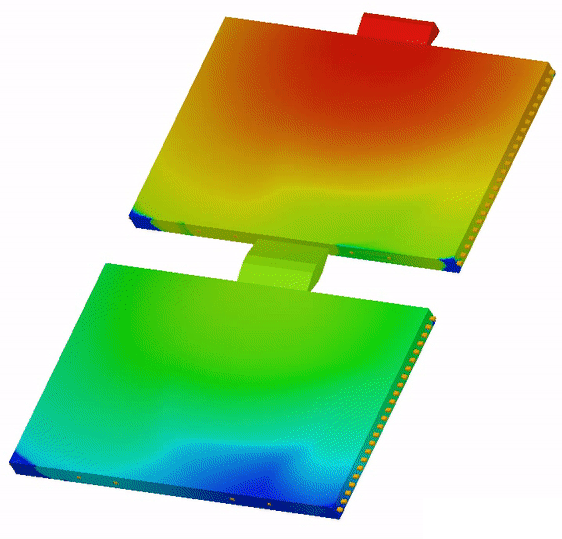 |
製程條件影響預測
- 模擬實際生產的多樣化製程條件
- 計算製程改變所造成的溫度、轉化率和壓力分布
- 預測氣泡缺陷(考量排氣效果)與翹曲
 |
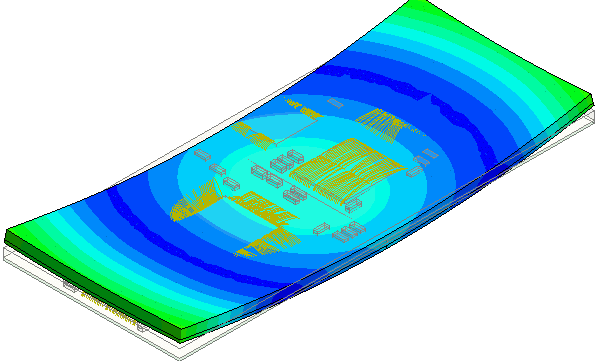 |
後熟化製程翹曲與應力分析
- 顯示經過後熟化階段的應力鬆弛和化學收縮現象
- 計算溫度、轉化率與應力分布並預測可能產生的變形

高階材料特性量測
- 可量測反應動力、黏度、黏彈性提供流動模擬
- 黏彈應力釋放、化學收縮率、熱膨脹收縮效應達成精準預測翹曲
 |
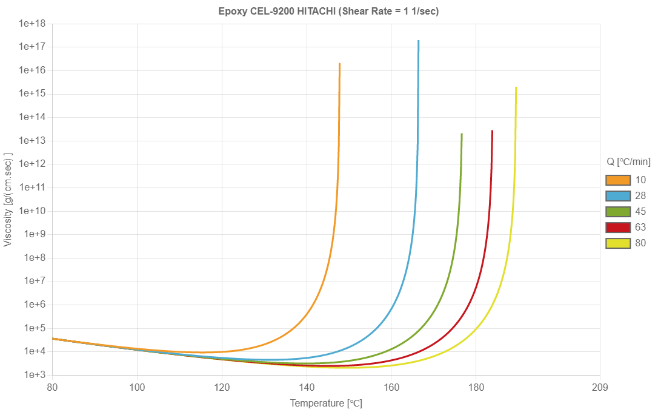 |
Moldex3D 支援多種封裝製程模擬轉注成型與覆晶底部填膠模擬。
轉注成型與覆晶底部填膠模擬
- 顯示流動與固化過程 ,優化澆口與流道設計
- 預測潛在成型瑕疵 ,模擬包封與短射
- 計算氣體區域內的壓降,優化排氣設計
- 評估製程條件與材料特性,縮短週期時間
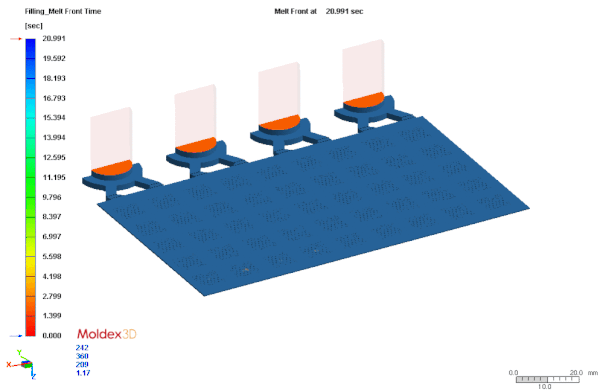
壓縮成型與晶圓級封裝模擬
- 顯示壓縮成型製程的動態流動波前
- 評估扇出型封裝之晶片偏移、翹曲行為與剪切應力分布
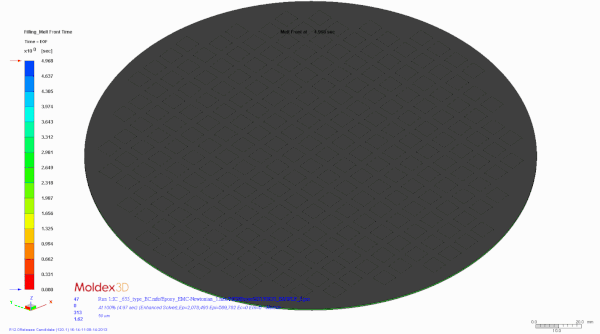
毛細底部填膠模擬
- 顯示在不同表面張力與接觸角度下,毛細力所產生的流動行為
- 評估接點間距與接點分布對流動的影響
- 最佳化底膠的點膠路徑設定
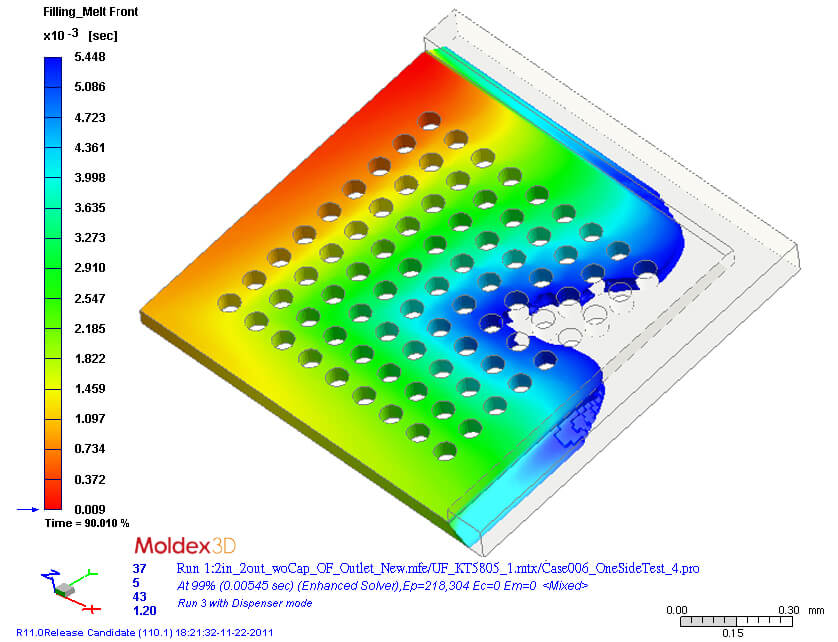 |
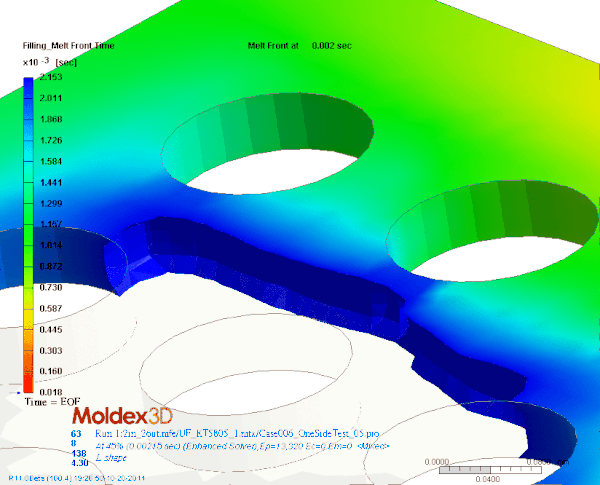 |
灌膠
- 更真實且詳細的點膠頭路徑及給料的可視化 (支援potting & dotting)
- 利用完整的物理模型來模擬表面張力引發現象,如爬膠
- 方便的建模工具及設定介面來重現多樣的製程設計