電子灌膠封裝
成就高精度電子灌膠未來
使用聚氨酯(PU)、矽膠或環氧樹脂進行電子灌封具有多重優勢:

Moldex3D 解決方案
透過 Moldex3D 電子灌封模擬技術,可針對在灌封過程中的流動應力進行模擬,並有效預測氣泡位置及大小。同時也提供溫度變化、化學反應、固化程度、相變化及收縮過程等綜合分析,以準確預測殘留應力分佈及評估產品外觀等缺陷。
製程設計確認並改善處理條件
- 流體、溫度、相場和熟化程度的模擬
- 考慮表面張力、毛細力和重力的影響
- 優化澆口和流道設計
- 氣泡包封預測

後熟化翹曲模擬
- 透過數值模擬觀察相變化過程
- 完整考慮應力釋放及化學收縮
- 透過溫度、熟化率及應力分布模擬,預測後熟化過程中的變形
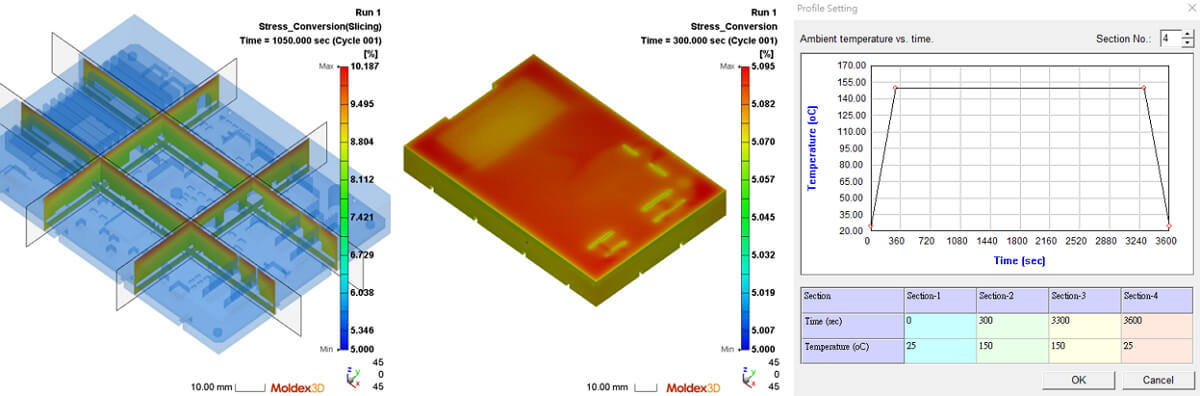
先進材料特性測量及模擬
- 測量熟化反應動力學、黏度及黏彈性特性,以進行流動模擬
- 量測黏彈性應力釋放、化學收縮及熱膨脹效應,應用於翹曲預測
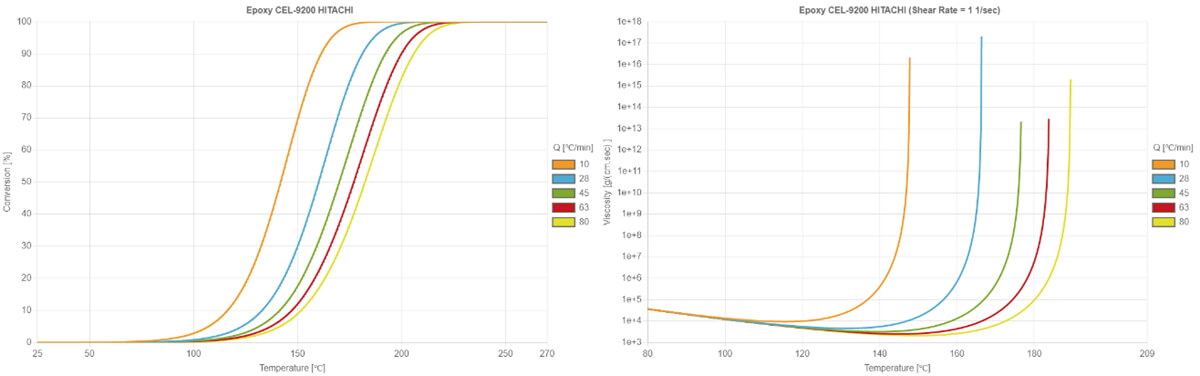
電子灌封常見應用
電子灌封 PCB 元件
常應用於板級封裝,特別是需以電子灌封增強 PCB 保護的各種電子產品。其封裝品質通常取決於封裝材料及封裝厚度一致性,在灌封製程中,排氣設計是最小化氣泡數量的關鍵,以滿足規格要求。
觀察空氣區的變化,在充填過程中氣泡的運動趨勢和停滯位置,幫助使用者改進產品和排氣設計,由於熟化及黏彈性效應,其應力分佈會隨著時間的推移而變化。Moldex3D 電子灌封模擬製程,有助預測最終殘餘應力和產品形狀,並有效控制氣體運動的態勢及避免包封形成。
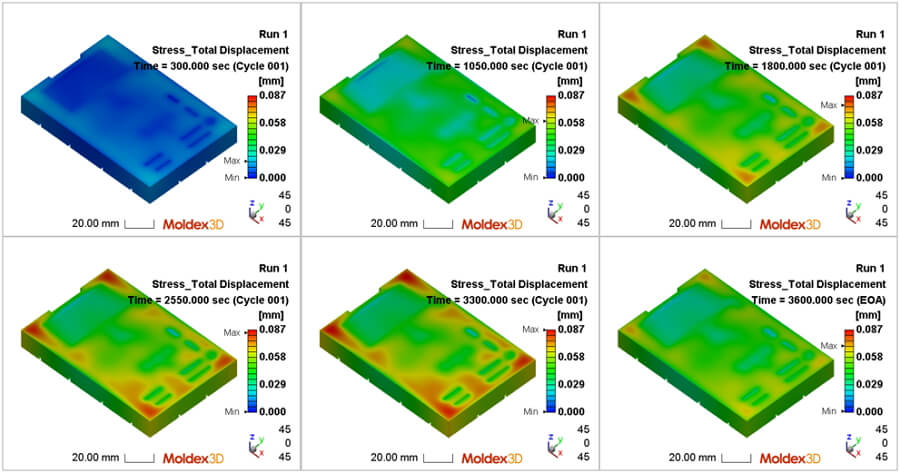
馬達轉子線圈的電子灌封
廣泛應用於馬達,常使用聚氨酯(PU)或環氧(Epoxy)以保護線圈纏繞組件,有效防止高速旋轉造成的磨損、因高頻振動而導致的脫落風險,以延長產品的使用壽命。針對控制電路板和微控制器,也能顯著降低產品的尺寸、慣性矩及功耗等。
Moldex3D 可預測灌封過程中氣泡行程和包封位置,有助選擇最適合的材料和最佳的製程參數及製程最佳化。灌封後的後熟化分析,可深入了解固化時間、化學收縮及因黏彈性效應引起的應力釋放。

行動電子產品的封裝填充
應用於高功率氮化鎵(GaN)充電器,能有效電氣絕緣、高效散熱,並保護電子觸點免受物理衝擊,使產品提高可靠性和產品壽命。
在灌封過程中,因組件間隙減少,產品設計和材料的選擇會顯著影響製造的良率和品質,利用數值模擬來獲得最佳設計參數和材料選擇至關重要。