 |
科盛科技技術支援處 工程師 賀資閔 |
IC封裝是指以環氧樹脂封裝積體電路的製程,目的是避免精密電子晶片受物理損壞或腐蝕。封裝過程需考量以下因素:微晶片與其他電子元件(即「打線」)、熱固性材料的固化反應,以及製程條件控制之間的交互作用。
Moldex3D Studio現提供晶片封裝轉注成型分析模擬,可幫助設計人員從充填、固化、冷卻等階段全面模擬及分析封裝過程。透過精準模擬可預測並解決重大成型缺陷,有助於提升產品品質並預防潛在問題,使用戶達成最佳化設計,同時縮減製造成本和週期。
操作流程
限制
- 模型中需要定義進澆口
- 以往前處理常需藉Rhino介面生成Moldex3D實體網格,現亦可於Studio生成(但需留意模型複雜性及對應工具是否齊備)。
步驟一:模型準備
- 在Moldex3D Studio中創建新組別,於「製程類型」中選擇「晶片封裝」。

- 準備模擬分析模型。網格完成後啟動「最終檢查」,或滑鼠單擊「匯入網格」以導入完成之網格檔(MFE)。
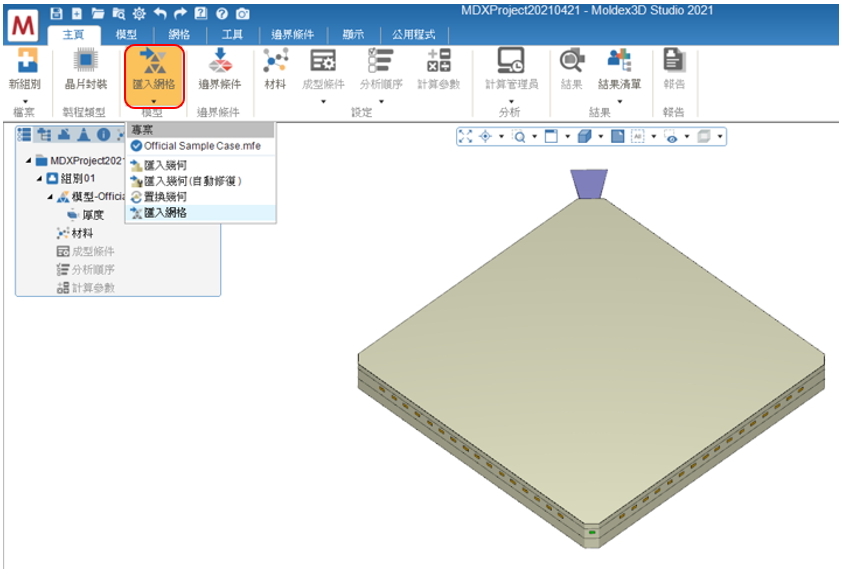
步驟二:材料及成型條件設定
在「材料樹」中為每個組件定義材料,接著於「成型條件」下拉選單並單擊「新增」以啟動加工精靈進行設置:(1)於「分析方式」選擇「轉注成型模組」。(2)逐步設置成型條件。
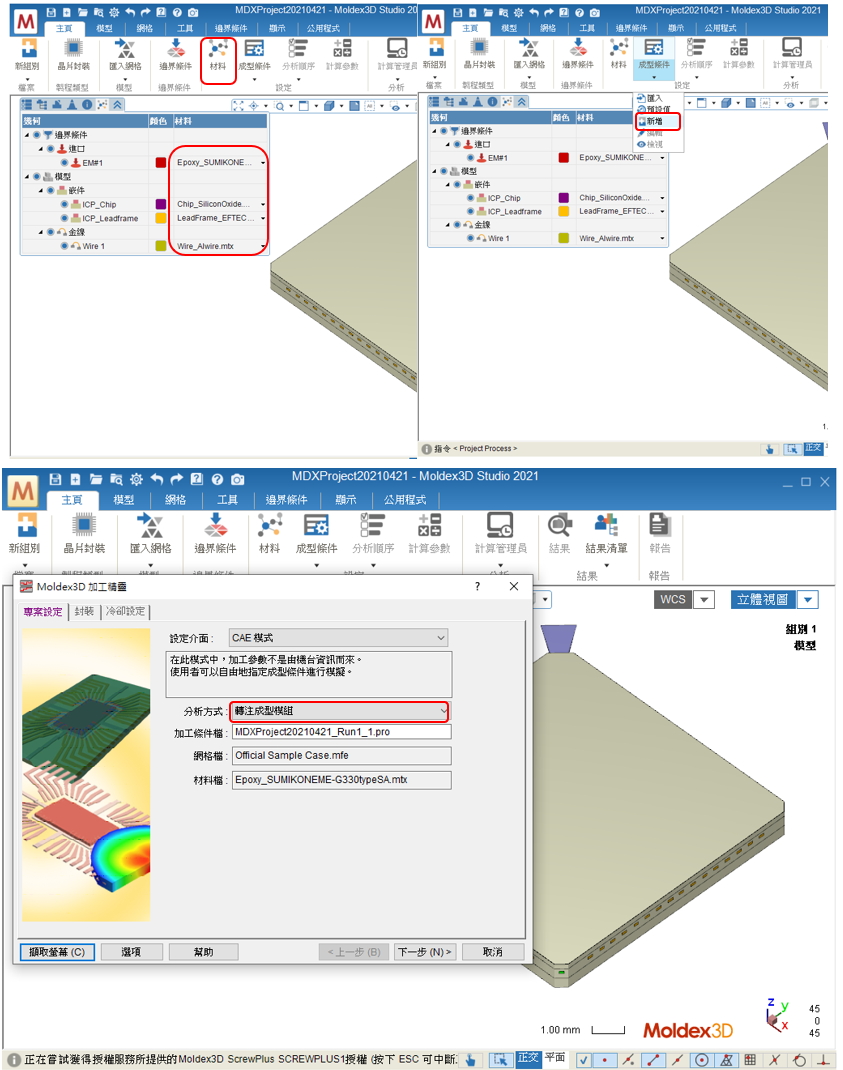
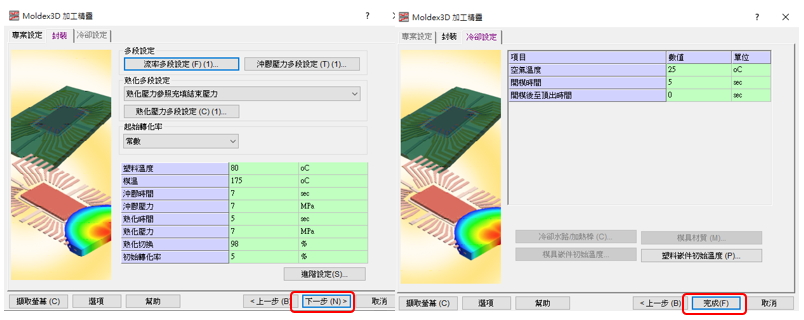
步驟三:分析設定
選擇「轉注成型分析2 – F C W」做為分析順序,用戶亦可透過「使用者自選」指定分析順序。
注意:另可使用「計算參數」中的「封裝」納入金線偏移分析和導線架偏移分析。

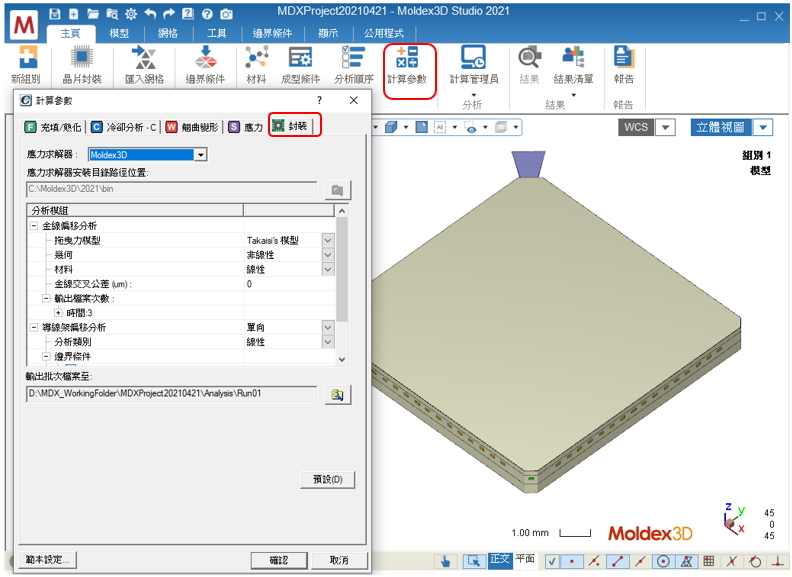
步驟四:提交分析
完成上述設定後,單擊「開始分析」啟動程式計算,Moldex3D將呼叫計算管理員供用戶檢視進度和詳細資訊。
注意:在提交模擬分析前,用戶可單擊「計算管理員」以更改平行和遠端計算設定。
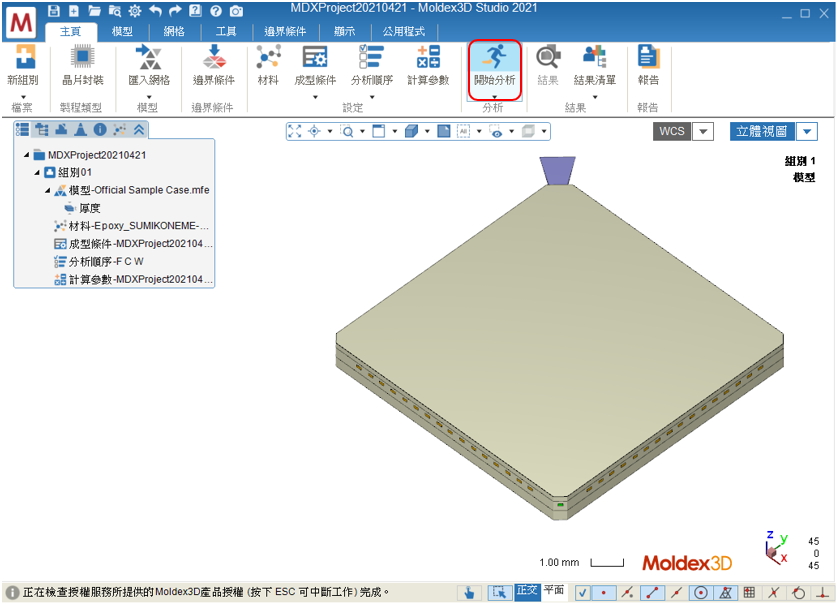
步驟五:結果檢查與報告匯出
分析完成後,結果將列於專案樹狀表的「結果」項下。單擊「結果」以從「主頁」切換到「結果」選項卡。用戶可於「結果」選項卡中使用不同後處理工具顯示自定或進階結果。
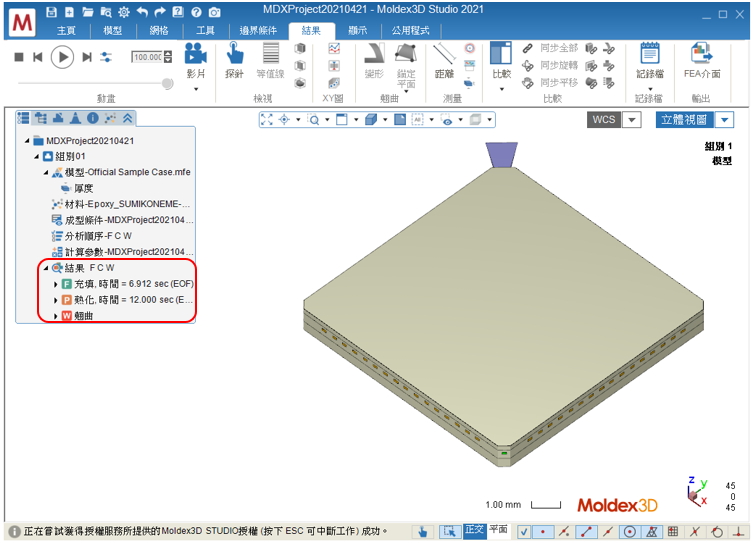
接著使用「報告精靈」自動生成報告。單擊「主頁」選項卡中的「報告」以設置格式並產出文件。可利用「偏好設定」自定義報告、圖檔、影片格式。最後指定報告名稱和存檔位置後,單擊「開始」以生成報告。