Moldex3D IC package 進階分析模組
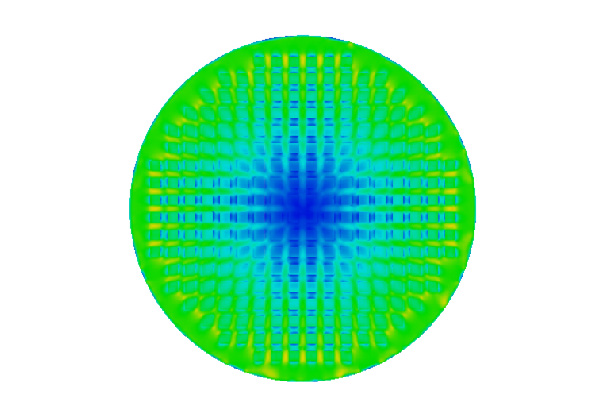 晶片封裝壓縮成型模組Compression Molding
晶片封裝壓縮成型模組Compression Molding
模擬高分子材料在壓縮過程中被擠壓到預熱模具的行為,幫助使用者檢查由熱與壓力造成的可能缺陷,並決定適合的材料與最佳化製程參數。
 晶片封裝底部填膠模組Underfill
晶片封裝底部填膠模組Underfill
可模擬三維流動情形,以及在波前處因表面張力作用造成的曲率分布與毛細現象,更進一步加入反應動力模式與黏度模式,以模擬覆晶底膠的充填行為。亦可讓使用者輸入真實的點膠設定,進而預測接點間隔 (Bump Pitch) 與接點分布 (Bump Pattern) 對充填過程的影響,提升產品良率,達成有效控制成本的目的。
 晶片封裝後熟化分析 Post Mold Cure
晶片封裝後熟化分析 Post Mold Cure
在Moldex3D後熟化技術中,是透過數值有限元素法整合PvTC與溫度-熟化-粘彈性鬆弛整合式的模型模擬完整後熟化過程。
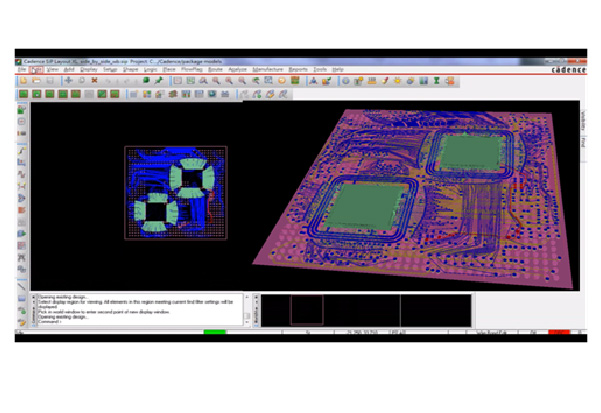 Cadence介面功能模組
Cadence介面功能模組
目前Moldex3D支援用戶直接將Cadence 的3di 檔案直接匯入Moldex3D進行網格處理接續模擬分析。其3di檔可以無損失的匯入完整的模型幾何,包含:環氧樹脂區域、矽晶片、導線架、金線和錫球等,並且也可以在匯入後,依照使用者需求做調整與幾何修正。