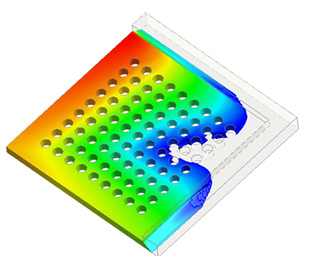
為什麼使用底部填膠模擬?
Moldex3D晶片封裝底部填膠模組支援毛細流動計算,在晶片與基板間的隙間以表面張力為驅動力的封裝行為,而表面張力將受環氧樹脂與各別組件接觸角的不同而有不同的驅動力。
一般來說覆晶都是較低的熱膨脹係數,所以容易在熱循環過程中影響發生變形;過度的變形將導致晶片機械疲勞、功能缺陷或斷裂問題。因此,底部填膠模擬製程被開發用來提高覆晶開發的品質與可靠度。
挑戰
- 考慮表面張力效應做精確的分析
- 預估環氧樹脂充填波前的穩定性
Moldex3D 解決方案
- 可視化晶片與基板間的毛細管現象所產生的充填行為
- 可視化動態點膠製程的充填行為
- 支援相同性質之多次重複點膠輸入
- 支援弧線路徑點膠
- 強化溢流區表面張力與重力平衡,分析點膠參數設定及環氧樹脂與組件間的接觸角
- 評估錫球間距離和錫球排列圖案對覆晶填充的影響
- 預測包封位置並防止充填產生的潛在缺陷
- 實現成型優化且降低成本
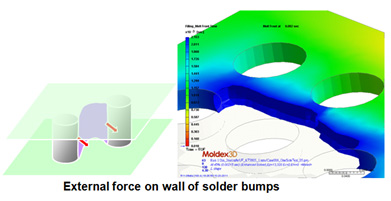
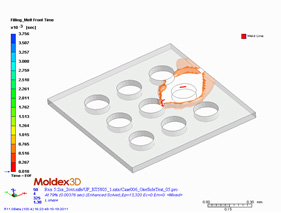
應用產業
- IC Packaging 晶片封裝產業
Moldex3D建議產品
- Moldex3D Advanced Package