  |
科盛科技研究發展部技術副理 孫嘉蓬 科盛科技研究發展部使用者經驗設計師 黃智揚 |
3C產品不斷朝輕量化及多功能發展,IC封裝的製程技術研發也隨之趨向小而精緻。面對使用壽命及可靠度的需求,如何採用最佳的配置進行封裝以減少缺陷發生,並提供產品最好的保護,是產業最重視的課題之一。由於影響封裝品質的變因項目會隨著製程複雜度增長,也使得研發階段尋求最佳化方案的難度提升;此外,IC封裝材料以及所使用的相關元件均價格不斐,因此在封裝研發的階段若能以透過CAE分析取代實驗試誤、及早找到最佳方案,便能大幅減少材料及運送等成本。
Moldex3D Studio的IC封裝解決方案提供以轉注成型(Transfer Molding)、成型底部填膠(Molded Underfill)、毛細底部填膠(Capillary Underfill)、灌膠(Potting)、壓縮成型(Compression Molding)等方式模擬封裝填料過程,並可輔以排氣分析 (Venting Analysis)、金線偏移分析 (Wire Sweep Analysis)、導線架偏移分析 (Paddle Shift Analysis)、後熟化分析 (Post Mold Curing Analysis)等功能,完成更真實的模擬。以下簡單說明Studio封裝模擬流程。
1. 製作模型
在製程類型(Molding Type)選擇晶片封裝(Encapsulation)(圖一),接下來可直接匯入已製作完成的網格,或是使用Studio的工具建立自己的模型。使用封裝組件(Encapsulation Component)精靈可以由2D曲線產生IC物件,並可指定位置及厚度,後續即可在產生網格時自動生成Hybrid網格(圖二)。要注意不同分析模組需有符合的屬性物件及進料類型,如壓縮成型分析需有壓縮區及移動面、灌膠分析需將進料路徑在溢流區。
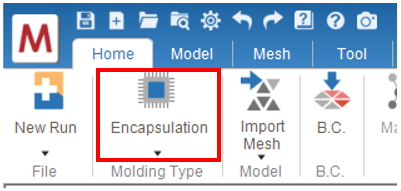
圖一 製程類型選擇晶片封裝

圖二 使用封裝組件產生Hybrid網格
2. 邊界條件設定
依照模擬類型,在邊界條件(Boundary Condition)頁籤會有不同邊界條件可以設定,對於毛細底部填膠分析、灌膠分析可於此設定打點式及灌膠式路徑;壓縮成型則可指定預填料(Charge);導線架偏移等分析需要將導線架固定面加上固定拘束邊界條件。

圖三 邊界條件(Boundary Condition)頁籤

圖四 灌膠路徑設定
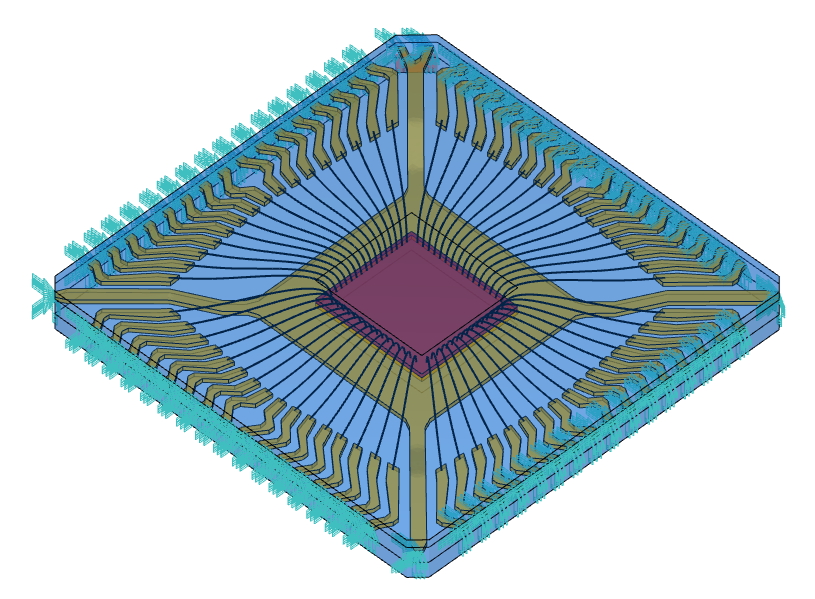
圖五 導線架設定固定拘束邊界條件
3. 材料設定
由Moldex3D材料庫指定各種屬性組件的材料,使用者也能依照各自情況自訂材料。

圖六 依照各物件屬性設定材料
4. 加工條件設定
若網格進澆(Inlet)設定在環氧樹脂(Epoxy)上,分析方式(Analysis Type)可選擇是轉注成型模組(Transfer Molding)、成型底部填膠模組(Molded Underfill)、毛細底部填膠模組(Capillary Underfill)(圖七);若網格包含壓縮區,分析方式可選擇為壓縮成型(Compression Molding)、嵌入式晶圓級封裝(Embedded Wafer Level Packaging, EWLP)、非流動性底部填膠(No-Flow Underfill);若已設定點膠/打點/灌膠路徑邊界條件(Dispensing/Dotting/Potting BC),分析方式會自動選擇並鎖定。需要考慮表面張力(Surface Tension)的製程如底部充填等,可依照流動行為,在進階設定中進行接觸角設定(圖八)。
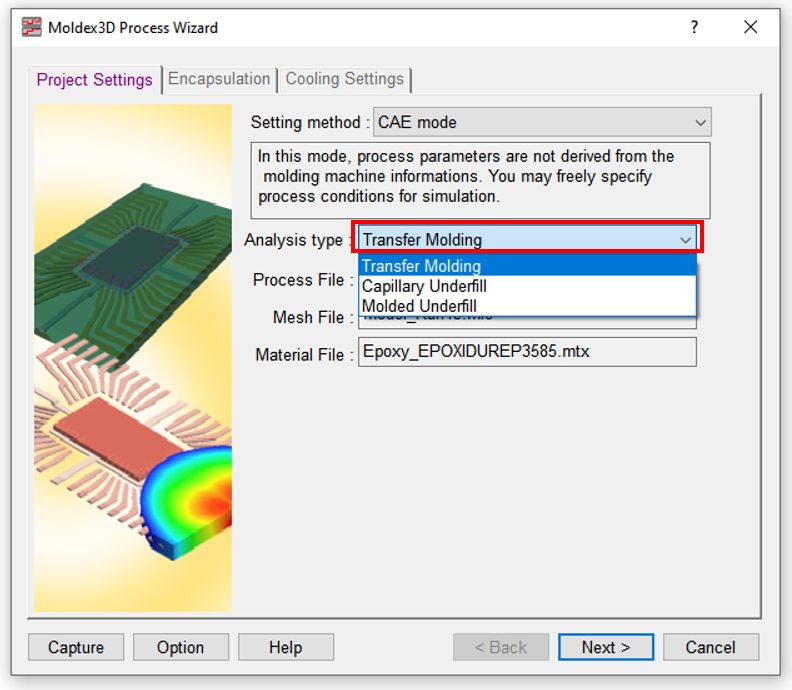
圖七 選擇分析方式
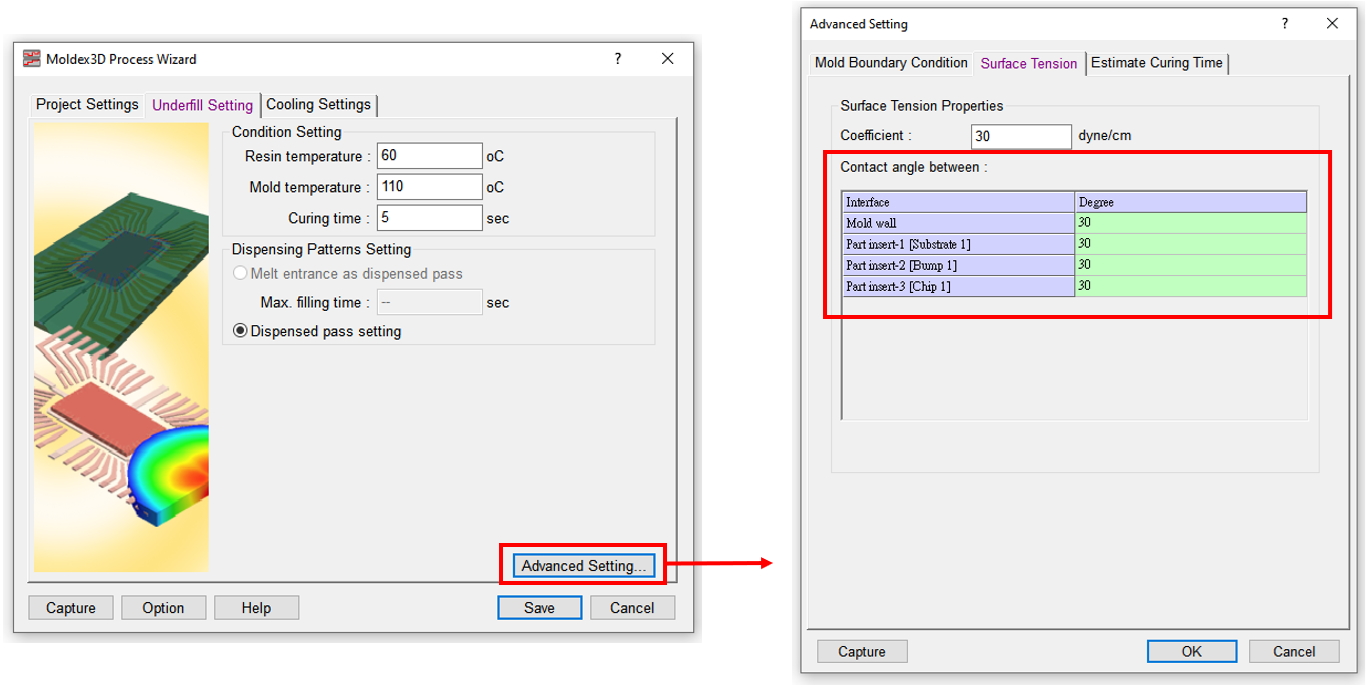
圖八 進階設定之接觸角設定
5. 分析序列
設定充填、熟化、翹曲等分析序列(圖九);金線偏移分析、導線架偏移分析也需將對應的分析序列設定在充填分析之後來考慮單向流固耦合(FSI)。若指定的是以充填分析-雙向導線架偏移(F/PS, Filling – Two-way Paddle Shift)取代 F+PS,則導線架偏移結果會考慮雙向流固耦合(FSI)並和充填結果一起產生。

圖九 分析序列設定
6. 分析設定
在封裝(Encapsulation)頁籤中,可針對金線偏移分析、導線架偏移分析選擇分析的應力求解器(Stress Solver),及分析所使用的計算模型;若在分析序列指定的充填-雙向導線架偏移分析(F/PS),在此可以設定雙向流固耦合數據交換步距(圖十)。

圖十 封裝頁籤選擇分析模型及指定雙向流固耦合數據交換步距
Studio封裝分析模擬結果視覺化呈現膠體充填/壓縮過程中的流動情況及氣泡產生位置(圖十一)、金線偏移(圖十二)、導線架偏移變形趨勢(圖十三)、底部充填毛細力流動行為(圖十四)等。使用者可藉此修改IC設計、製程參數來避免氣泡產生、金線重疊、導線架偏移量過大等缺陷產生,免去實驗試誤的過程,更有效率地提升IC封裝設計品質。
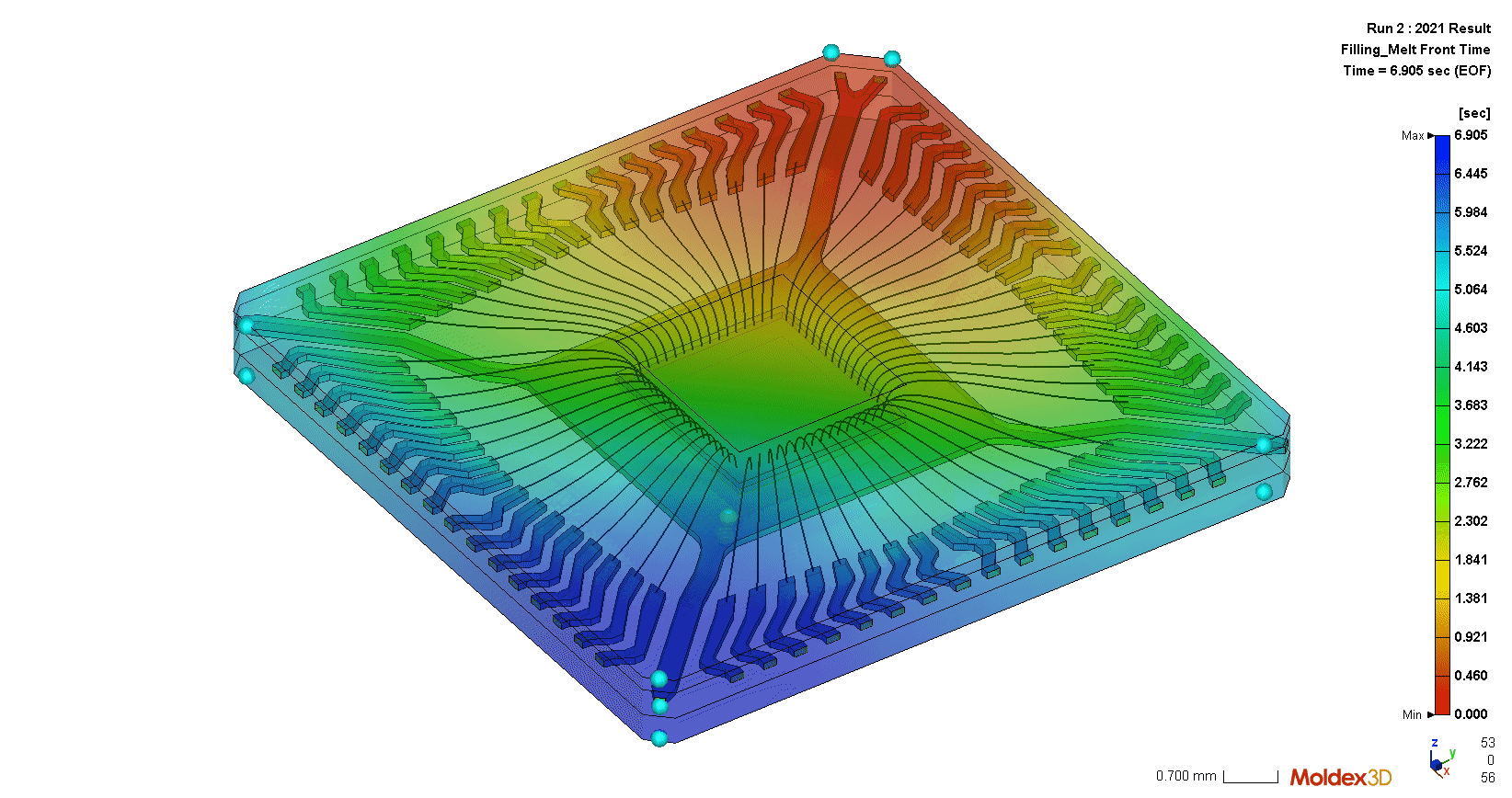
圖十一 視覺化呈現膠體流動行為及氣泡產生位置

圖十二 金線位移搭配變形功能,顯示金線變形趨勢
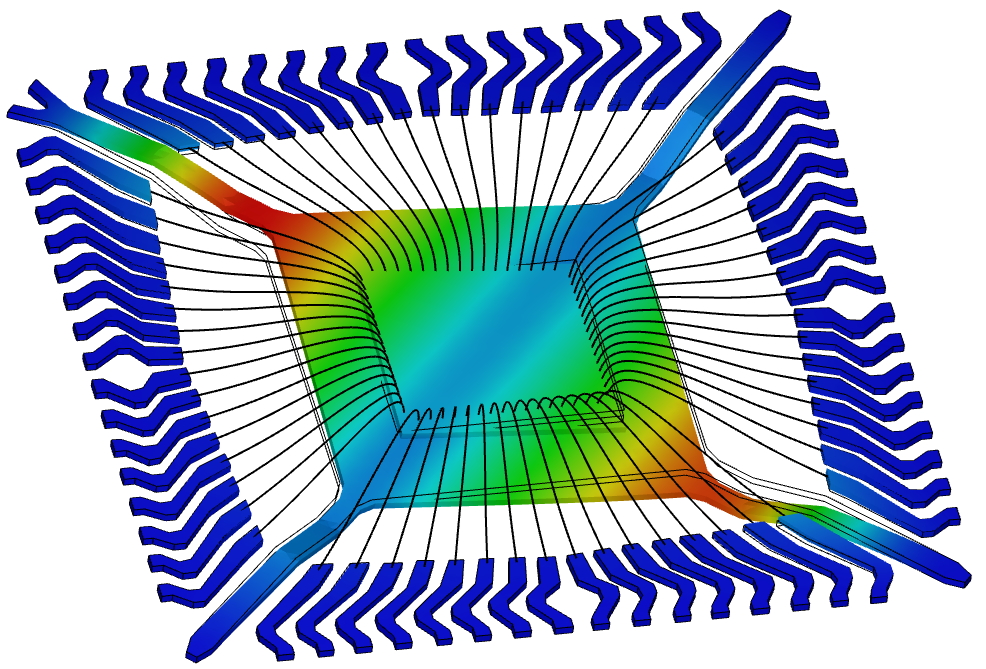
圖十三 導線架位移 – 總位移變形結果