由於晶片封裝組合種類多且相當複雜,整體受到EMC、晶片、導線和導線架不同元件之間的熱傳導差異影響,使得翹曲變形成微IC封裝製程中最常見問題。Moldex3D晶片封裝翹曲分析為實體(3D)網格分析;透過充填流動、熟化分析結果取得因溫度和熟化效應的收縮資訊,進行翹曲變形的預測。
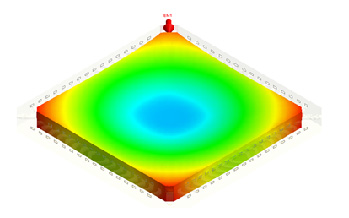
Moldex3D晶片封裝翹曲分析
功能
- 預估材料熟化引起的收縮
- 預估材料熱收縮變形
- 評估應力鬆弛行為
- 將總位移分為三軸顯示每個方向(x軸,y軸和z軸)的變形

由於晶片封裝組合種類多且相當複雜,整體受到EMC、晶片、導線和導線架不同元件之間的熱傳導差異影響,使得翹曲變形成微IC封裝製程中最常見問題。Moldex3D晶片封裝翹曲分析為實體(3D)網格分析;透過充填流動、熟化分析結果取得因溫度和熟化效應的收縮資訊,進行翹曲變形的預測。
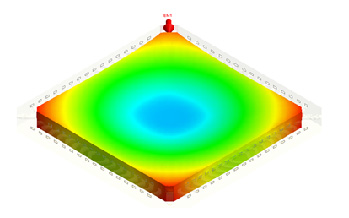
Moldex3D晶片封裝翹曲分析
