IC封裝中的毛細底部填膠(Capillary Underfill, CUF)製程,是將環氧樹脂(Epoxy)點膠在覆晶(Flip chip)的側邊,在表面張力的驅動之下進行底部填膠。Moldex3D晶片封裝模組支援毛細底部填膠分析,可以模擬毛細流動。
環氧樹脂在填膠過程中會與不同材質的元件接觸,例如基板(PCB)、錫球(Solder ball)、晶片(Silicon die)等。由於在交界面上會有不同的表面張力性質,為了縮短模擬分析和真實製程的距離,提升分析的準確度,Moldex3D加工精靈(Process Wizard) 支援不同接觸角的設定,並提供使用者介面針對各別接觸物件來給定不同接觸角。
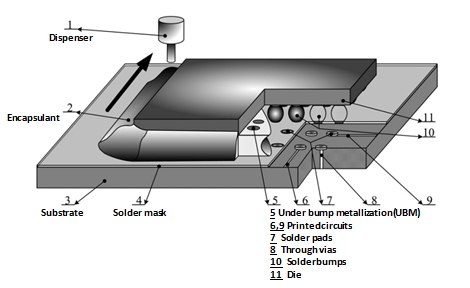
Flip-chip capillary underfilling process
操作流程─在填膠分析中,不同嵌件材料的的接觸角設定
步驟1 首先建立一個晶片封裝成型專案,並匯入毛細底部填膠模型。本案例共含有4種不同的嵌件(Part insert)材料,會與環氧樹脂接觸的有錫球、晶片、銅墊(Cu Pad)與直通矽晶穿孔(Through Silicon Via, TSV)。
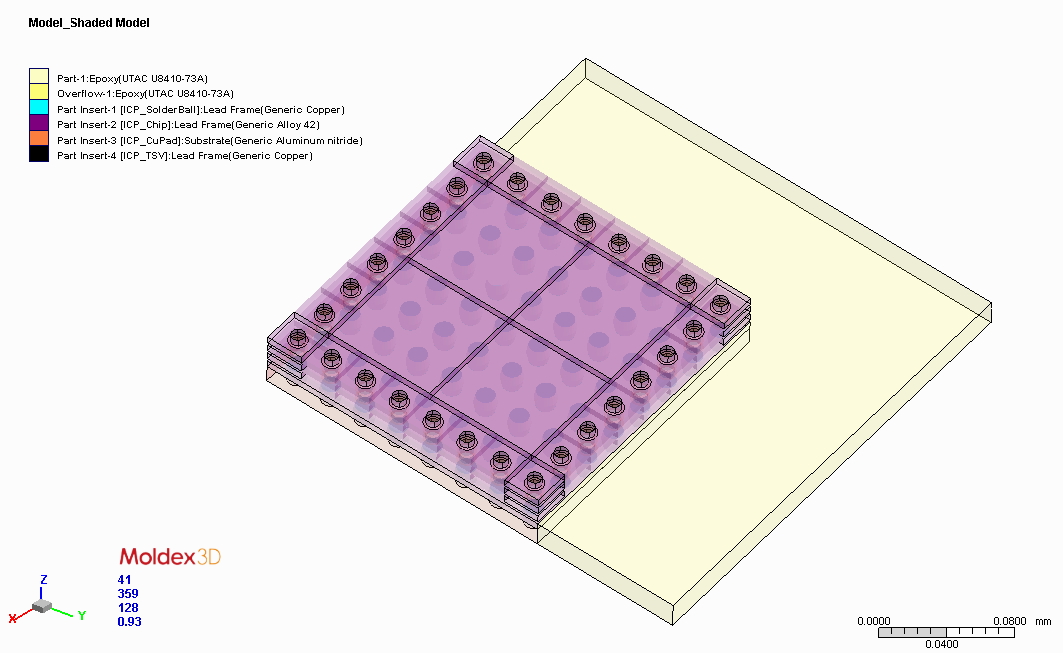
毛細底部填膠案例
步驟2 開啟加工精靈,在分析方式(Analysis type)項目選擇毛細底部填膠模組(Capillary Underfill),並在底部填膠設定(Underfill Setting)的頁籤點擊進階設定。並切換至表面張力(Surface Tension),在此為環氧樹脂指定表面張力係數及其與不同嵌件之間的接觸角度。
加工精靈設定頁面
步驟3 完成其他專案設定並執行流動分析後,即可觀察不同接觸角設定對流動波前的影響。本案例套用共三組不同的設定:A是皆為30度的情況;B是皆為10度的情況;C接觸角各自不同的情況。由各組的分析結果可以得知,當接觸角的設定不同時,的確會影響到流動波前的預測,而呈現不同的趨勢。